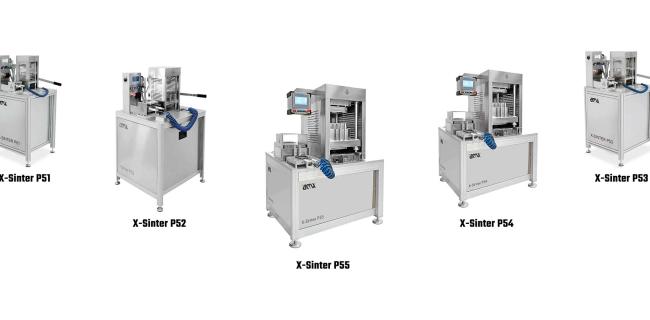





Ein innovativer Prozess von AMX
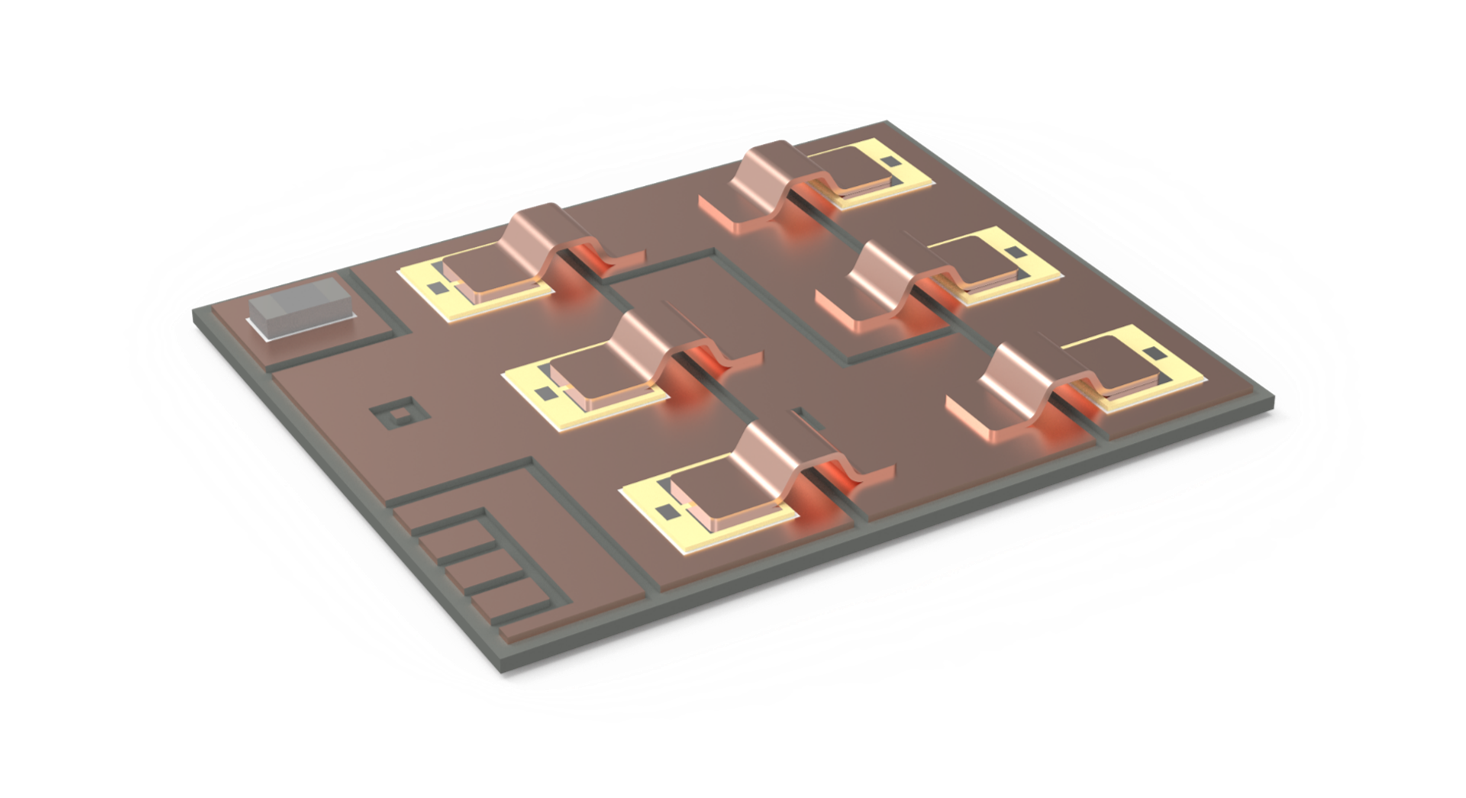
Clip-Sintern, Cu-Folie und andere Komponenten auf der Halbleiteroberseite.

Kernanwendung, bei der SiC/IGBT/MOSFET Matrizen auf Substrate (DBC oder AMB) gebondet werden. Sie sorgt für das gleichzeitige Sintern verschiedener Komponenten (z. B. NTC-Thermistoren, IGBR-Widerstände, Clips, Abstandshalter und Säulen) innerhalb eines einzigen Produktionszyklus.
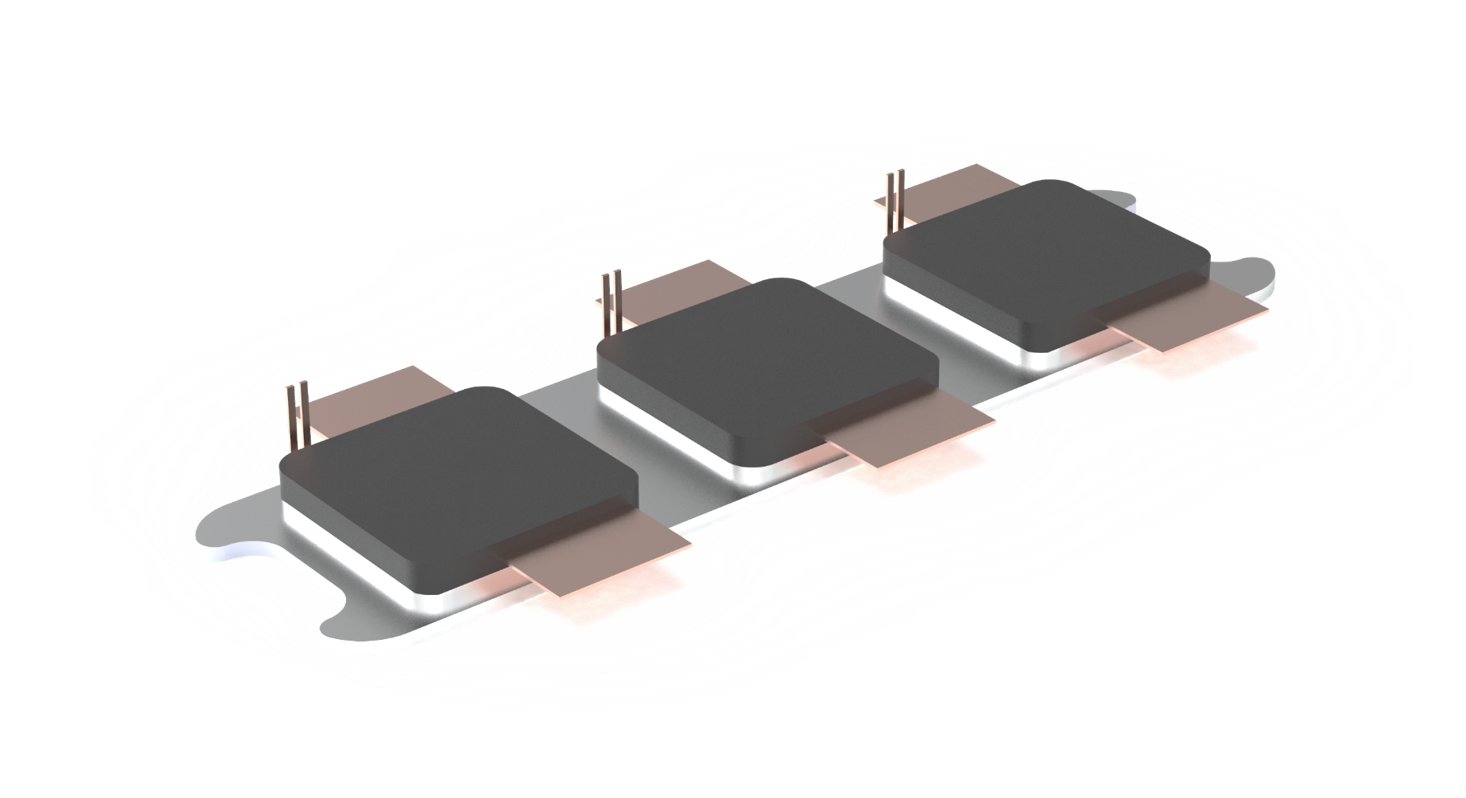
Ein starker Trendprozess

Es werden in Front-End-, Mid-End- und Back-End-Prozessen eingesetzt, ermöglichen hohe Leistung und verbessern die Markteinführungszeit erheblich.

Bildung komplexer mehrschichtiger 3D-Strukturen, bei denen das gesamte Gehäuse, einschließlich der Chips, Sensoren, Rahmen und der zweiten DBC-Schicht oben, gesintert wird, um die bidirektionale Wärmeableitung zu optimieren.